【ITBEAR科技资讯】1月18日消息,据最新研究报告披露,台积电正在大幅提升其系统级集成单芯片(SoIC)的产能规划。按照新的计划,到2024年底,该公司的SoIC月产能将飙升至5000-6000颗,以满足人工智能(AI)和高性能计算(HPC)领域的迫切需求。
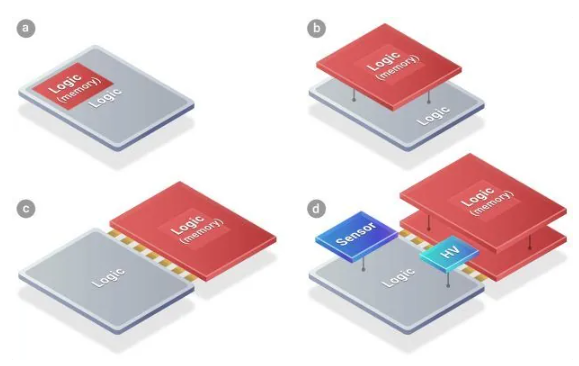
AMD作为台积电SoIC技术的首个合作伙伴,其AI芯片新品MI300结合了SoIC和CoWoS封装技术。如果MI300取得市场成功,它将成为台积电SoIC技术的一个重要里程碑。此外,据ITBEAR科技资讯了解,台积电的另一大客户苹果公司也对SoIC技术表示出浓厚兴趣。苹果正在小规模试产采用SoIC技术与热塑碳纤板复合成型技术相结合的产品,并计划在2025-2026年实现量产,目标应用于Mac、iPad等设备。这种制造方案的成本优势相较于当前的生产方式更为显著。

业内专家分析认为,苹果选择这一技术路线是基于其产品设计、市场定位以及成本控制等多方面的综合考虑。如果未来SoIC技术能够成功应用于笔记本电脑、智能手机等消费电子产品,将有望进一步激发市场需求,并促使更多大客户跟进采用。
台积电的SoIC技术是业内首个实现高密度3D chiplet堆叠的解决方案。该技术通过在芯片之间创建键合界面,实现了芯片的直接堆叠。在封装技术领域,凸点间距(Bump Pitch)是衡量封装集成度和难度的重要指标。台积电的3D SoIC技术的凸点间距最小可达到6um,领先于其他封装技术。
作为一种前沿的3D封装技术,SoIC在台积电的异构小芯片封装战略中扮演着关键角色。与CoWoS和InFo技术相比,SoIC提供了更高的封装密度和更小的键合间隔,并且可以与CoWoS/InFo技术相结合使用。基于SoIC的CoWoS/InFo封装将进一步减小芯片尺寸,实现多个小芯片的集成。
有消息人士透露,SoIC技术在2023年底的月产能预计为2000颗,原计划是在2024年扩大至3000-4000颗。然而,最新的产能规划已经上调至5000-6000颗,并且2025年的目标月产能有望实现再次翻倍。与此同时,经过15年发展的CoWoS技术预计到今年年底将实现月产能30000至34000件。












